
製品情報
- EBEP処理装置
- 電子ビーム励起プラズマを用いた
高密度プラズマ処理装置
▶ 詳 細
- 概 要
- EBEPとは電子ビーム励起プラズマ(Electron Beam Excited Plasma)の頭文字を並べたものです。
本装置は(独)理化学研究所の特許の実施権を取得して改良を加え、装置化したものです。
※広い圧力領域において低エネルギー、大電流電子ビームにより、プロセスガスを高効率に解離、
電離を行なうことができ、高密度の活性種を生成することが可能
(圧力 : 10-3~ 1Pa 電子密度 : ~ 1012cm-3)
⇒ CCPプラズマ、ICPプラズマでは達成できないプラズマ状態を生成
⇒ 様々な材料の精密成膜、エッチング、表面改質が可能
※ 酸化物、金属、樹脂等の成膜、表面改質に対応
※ ステージ加熱(Max 500℃)、バイアス印加による高速高精度処理が容易
- 動作原理
- EBEPは低エネルギー電子ビームをプロセスガスに衝突させることでプラズマを生成します。
電子ビームによる衝突でプロセスを活性化することから電子ビーム(Electron Beam Exclted Plasma)
と呼ばれます。
プロセスガスが外部エネルギーにより活性化する確率を断面積という言葉で表し、この断面積を最大に
する最適なエネルギー値がプロセス活性化の各反応ごとに存在します。
EBEPの電子ビームは電子の加速電圧と電流量が可変ですので、プロセスに応じた最適な断面積を得る
電子ビームを生成できます。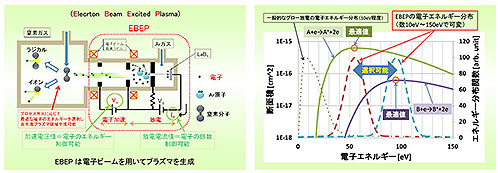
- 処理適用例
- ■ 窒化処理
窒化処理とは、金属熱処理の一つです。
活性化した窒素を金属表面に拡散、もしくは化合物を生成して表面硬化させる技術です。
EBEPでは高密度窒化プラズマによる迅速窒化処理、またはニッケル基合金やアルミニウム
合金など従来難しいとされていた金属にも窒化処理が可能です。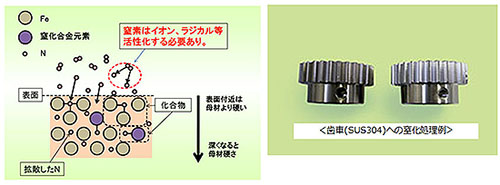
- ■ 表面改質
基材表面のみの性質を変化させる処理は表面改質と呼ばれます。
EBEPは100℃以下の低温も可能です。
樹脂材や硝子に対して親水性向上やイオンによる物理エッチング等の表面改質
プロセスが行えます。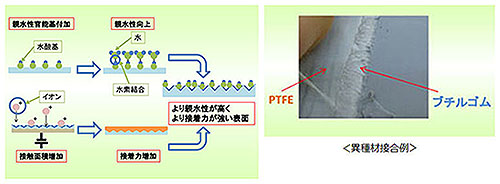
- ■ 表面改質
- イメージ画像
- ※ 画像をクリックしてください

- 仕 様

- 三元マグネトロンスパッタ装置
- 3つのターゲットで同時成膜可能な
スパッタ装置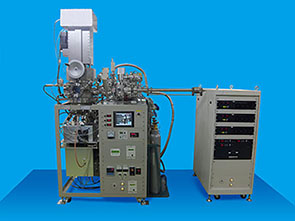
▶ 詳 細
- 概 要
- ・ 三元同時スパッタによる新素材の薄膜開発
・ 多元同時スパッタ以外にも、白金ヒーターを採用することで、基板の高温活性化
(ヒータ温度:950℃)や反応性スパッタなど様々な使い方に対応
※ ターゲット材料、導入ガスについては御相談下さい。
※ お客様の実験内容や予算に応じて仕様のカスタマイズが可能です。
※ アシスト用プラズマ源も対応可能(ECR、ICP、他)
- 動作原理
- スパッタリングとは成膜方法の一つです。
Arなどの不活性ガスをRFやDCなどの電源を用いてイオン化し、イオンをターゲットに高速で衝突させることで
粒子が飛散します。この粒子をスパッタ粒子と呼び、目的の基板上に推積されることで成膜を行います。
弊社のスパッタリング装置は電極に磁石を埋め込み、電源にRFを採用したマグネトロンスパッタ装置です。
標準で3基のRF電源を備え、3種のターゲットを同時にスパッタ可能です。
また白金ヒーターを採用することにより、酸化雰囲気でのプロセス及び、反応性スパッタリングに対応致します。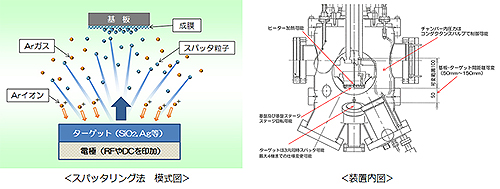
- プロセス例
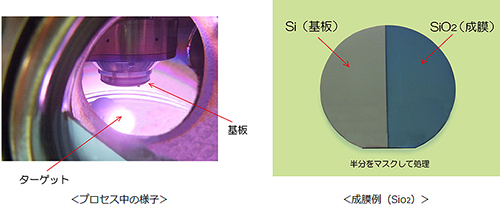
- 成膜特性代表例

- CCP型プラズマエッチング装置
- プラズマ生成とバイアス機能を備えた
2周波エッチング装置
▶ 詳 細
- 高真空蒸着装置
- 基板傾斜機構搭載高真空蒸着装置

▶ 詳 細
- 名古屋大学共同開発プラズマ装置
- 名古屋大学 電子情報システム専攻 堀研究室の研究結果を元に、弊社と名古屋大学発ベンチャー、
NU-Reiとの共同で開発したプラズマ装置を御提供致します。 御購入に関しては販売店のNU-Reiに
お問い合わせください。
- 共同開発したプラズマ装置
- ラジカルモニター <Radimo-DP,SP>
- 世界初、プロセスで使える超小型
ラジカル絶対密度計測装置
▶ 詳 細
- 概 要
- 各種プラズマ技術を用いて行うエッチング・表面処理・薄膜作製プロセス時に おいて、 プラズマ中に生成され、
これらプロセスに重要な役割を果す各種原子状 ラジカルの絶対 密度を計測し、プロセスへのフィードバックを可能
としたモニタ リング装置です。
※ 水素、窒素、酸素の原子状ラジカルを真空紫外吸収分光法を用いてダイレクトに計測し、プロセスにフィードバック可能
※ ICF70フランジに取付可能
※ 各種プラズマ装置に取付可能 (EBEP処理装置, CCPエッチング/CVD, Catプロセス/CVD, ICPエッチング/CVD等)
※ 真空排気系一体制御型モニタリングシステム等、システム構成はお客様のニーズに対応
- ラジカルモニターとは
- ラジカルモニターとはプラズマなどに存在する基底順位の原子状ラジカルを吸収 分法により計測する装置です。
計測用ソフトウェアは、名古屋大学堀研究室での研究成果にて校正された最新のものが搭載されています。
- 仕 様

- 特 徴
- ※ 小型、安価、取り扱い容易
※ 各種ガスが使用可能
※ 高い電子密度(1015 個/cm3 )
※ 大気圧下でプラズマ発生
※ 微小スポットプラズマ
- 概 略 図
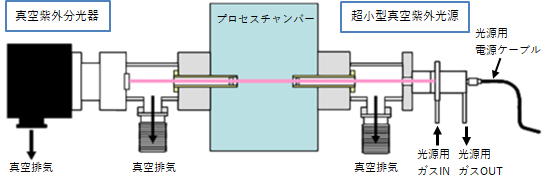
- 構 成
- ※ ラジカルモニターヘッド
※ 制御電源
※ 小型真空紫外分光器、波長帯域:115~170mm、波長分解能:0.8mm
※ 真空排気系
※ データ解析装置
※ ガス供給系
- VUV分光器
- 真空紫外光用の小型分光器

▶ 詳 細
- 各種ナノカーボン堆積装置
- ナノカーボン材料を合成可能なCVD装置

- 超高密度室温大気圧プラズマ装置
- 電極構造の工夫により高電子密度、
非平衡大気圧プラズマの生成を可能とし、
使いやすい大気圧プラズマ装置を実現しました。
▶ 詳 細
- 概 要
- ホロー電極構造におけるホロー効果を活用して高電子密度の生成を促し、高密度プラズマを実現しています。
さらに、電極間距離の最適設計により、大気圧下でのプラズマ生成が可能となっております。
また、プラズマ発光部照射による処理を行うため、放電ガスブローの調整により、噴出プラズマの形成が可能
となっております。 - 仕 様
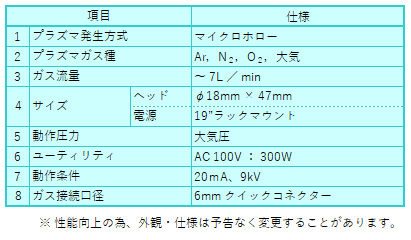
- 特 徴
- ※ 小型、安価、取り扱い容易
※ 各種ガスが使用可能
※ 高い電子密度(1015 個/cm3)
※ 大気圧下でプラズマ発生
※ 微小スポットプラズマ
- 構 成
- ※ 大気圧 μ ホロー電極構造プラズマヘッド
※ 制御電源 ※ プラズマガス(ご準備下さい)
※ レギュレーター(ご準備下さい)
- ガス供給
- ■大気圧マイクロホロープラズマ
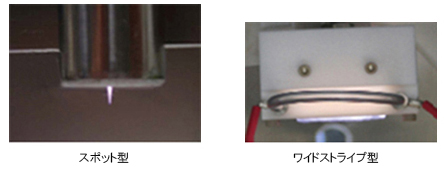
- 自律型制御機構(オプション)
- ■ 応用例
※ 金属・樹脂の表面改質(親水性の向上)
※表面クリーニング(電子部品の表面付着物除去等)
※ 金属・樹脂改質加工
- 様々なオプション付大気圧プラズマ
- ※ 高出力大気圧プラズマ装置
※ ロボット搭載型
※ 連装式大気圧プラズマ装置
※ モニター ※ 反応性ガス対応プラズマ装置
※ 密閉ボックス対応